
JIB-PS500i 双束加工观察系统
详细介绍
新型样品制备解决方案!
JIB-PS500i提供三种协助TEM样品制备的解决方案,是最适用样品制备和分析的FIB-SEM系统。

功能1. TEM-LINKAGE
双倾样品盒和TEM样品杆使TEM ⇔ FIB之间的连接更简单。样品盒可单触安装到专用的TEM样品杆上。
@ 双倾样品盒的样品传送流程

@ 样品室内机械手
采用Oxford Instruments 公司制造的的OmniProbe 400,可以实现精准快速的采样操作。JIB-PS500i的软件兼容OmniProbe 400的操作。


样品:5nm设计规则半导体器件 (FinFET)
观察条件:(左)加速电压2kV,检测器SED二次电子像,(中,右)加速电压200kV,TEM像,使用仪器:JEM-ARM200F
功能2. CHECK-AND-GO
为了准确有效地制备TEM样品,实地检查制样效果很重要。JIB-PS500i 能够从TEM制样无缝转移到STEM观察。薄片加工⇔STEM观察之间反复切换、可有效地制样。
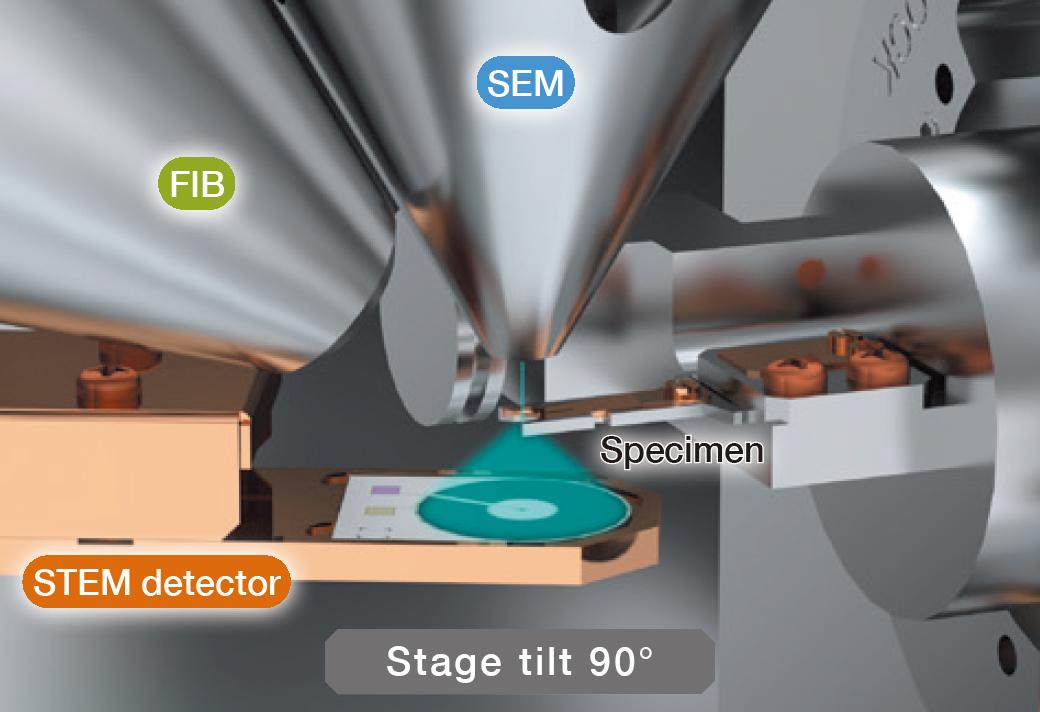
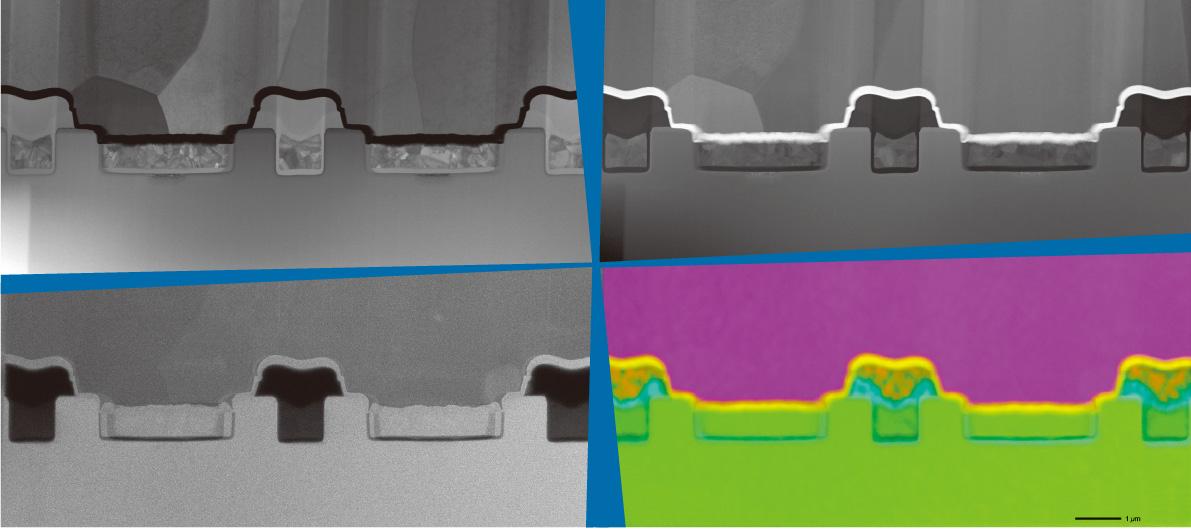
样品: SiC功能半导体器件 观察条件:加速电压30 kV、检测器(左上)STEM-BF、(右上) STEM-DF、(左下) SED 二次电子像、(右下) EDS元素分布图 紫: Al 黄: Ti 橙: P 蓝: O 緑: Si
功能3. AUTOMATIC PREPARATION
通过自动TEM制样系统STEMPLING2,自动化制样。制备的样品质量不会因操作人员的技能而出现偏差。
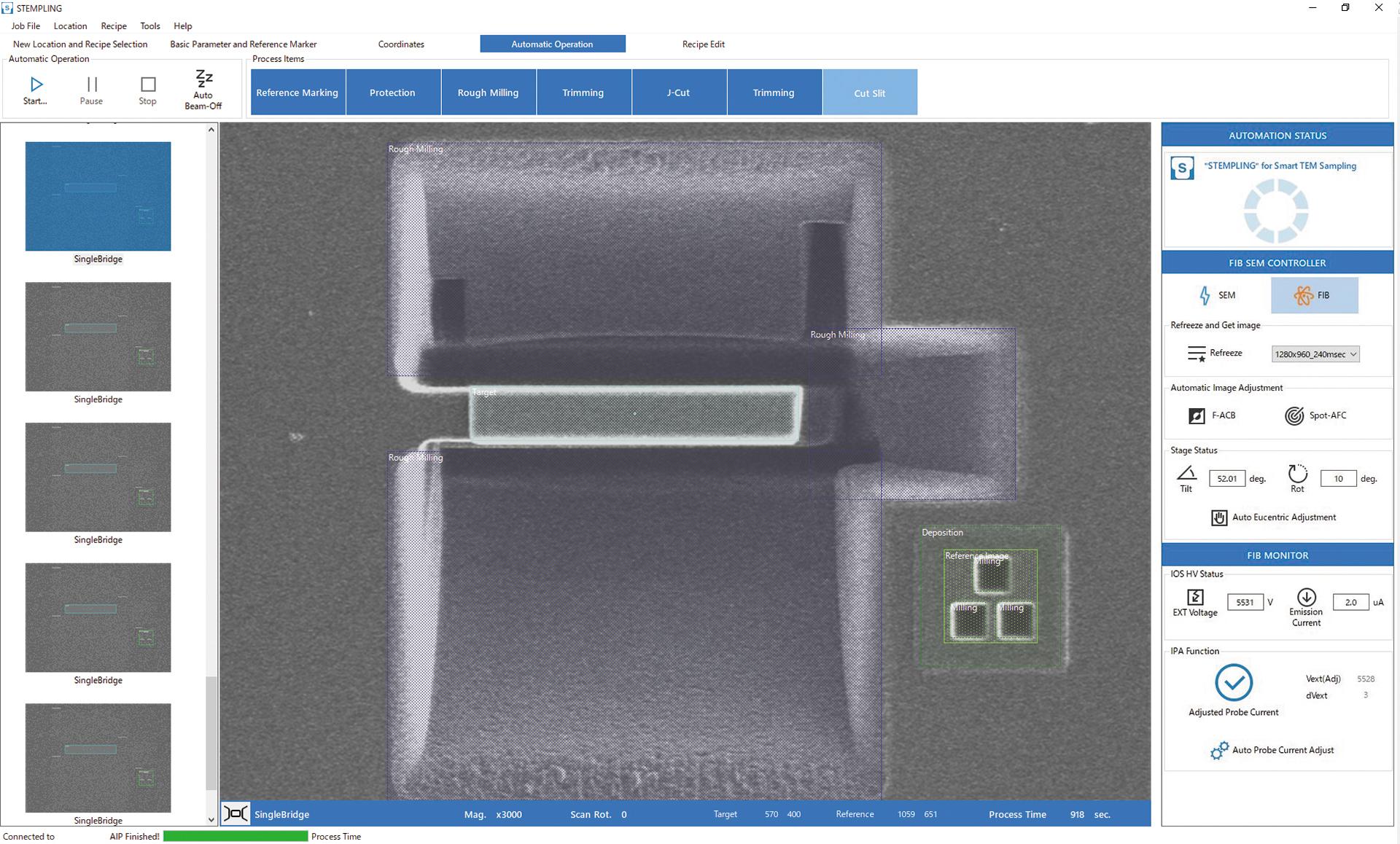
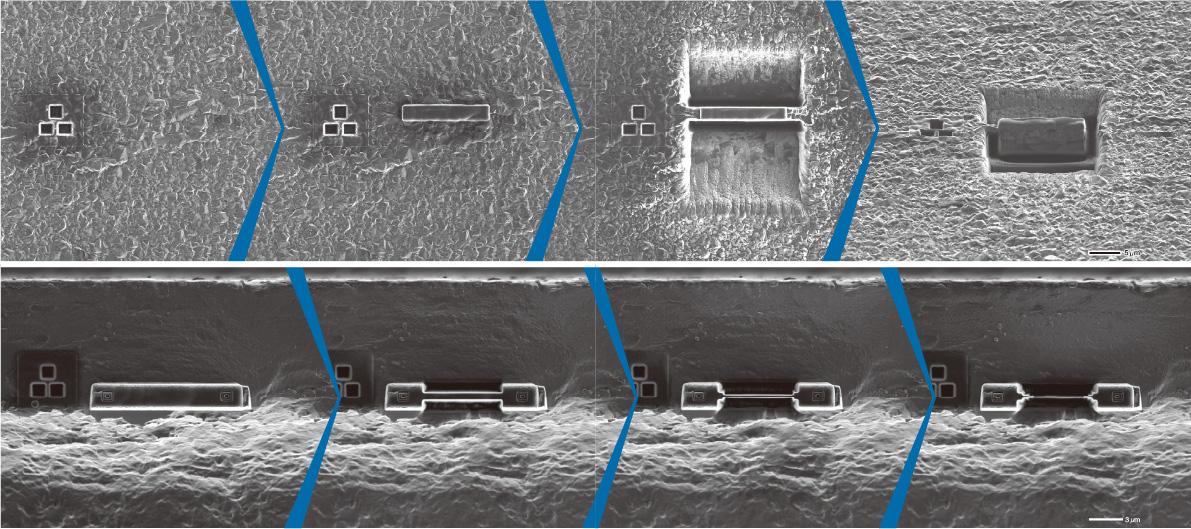
样品:铜镀层 (上部) 自动制备样品块、(下部) 样品块自动被加工成薄片 观察条件:加速电压30 kV、检测器SED (SIM像)
HIGH-RESOLUTION & HIGH-CONTRAST SEM Imaging
不再迷茫,不放过加工终点的高品质SEM图像
!Signal detection system
配备多个检测器,包括标配的SED、UED、iBED。对应各种样品,根据用途选择适合的检测器,进行有效观察。
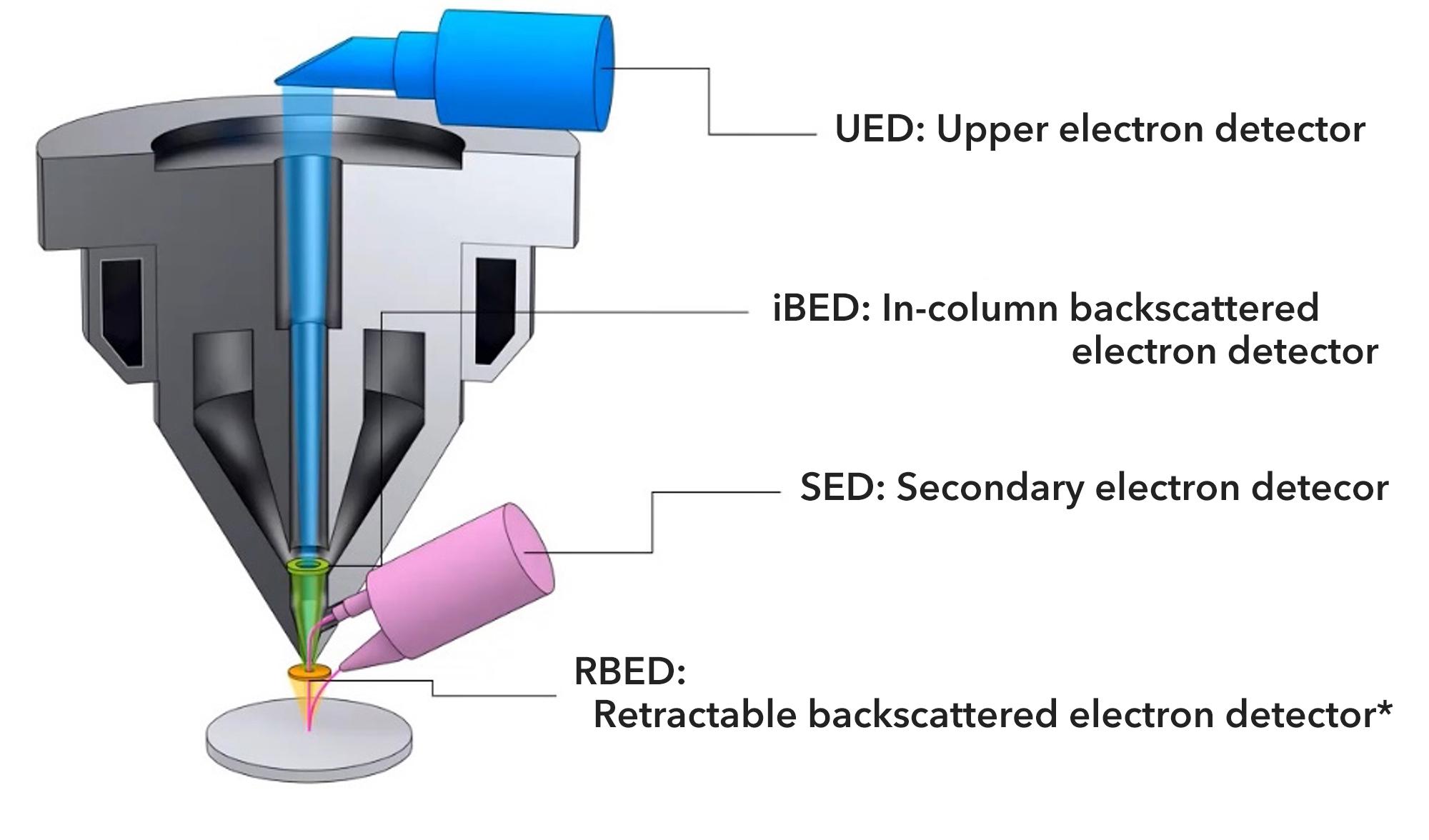
!High resolution SEM imaging
SEM镜筒内置了超级圆锥形透镜系统,显著地提高了低加速电压下观察性能。作为确认薄片加工终点用的SEM、可以采集到衬度好的鲜明的图像。
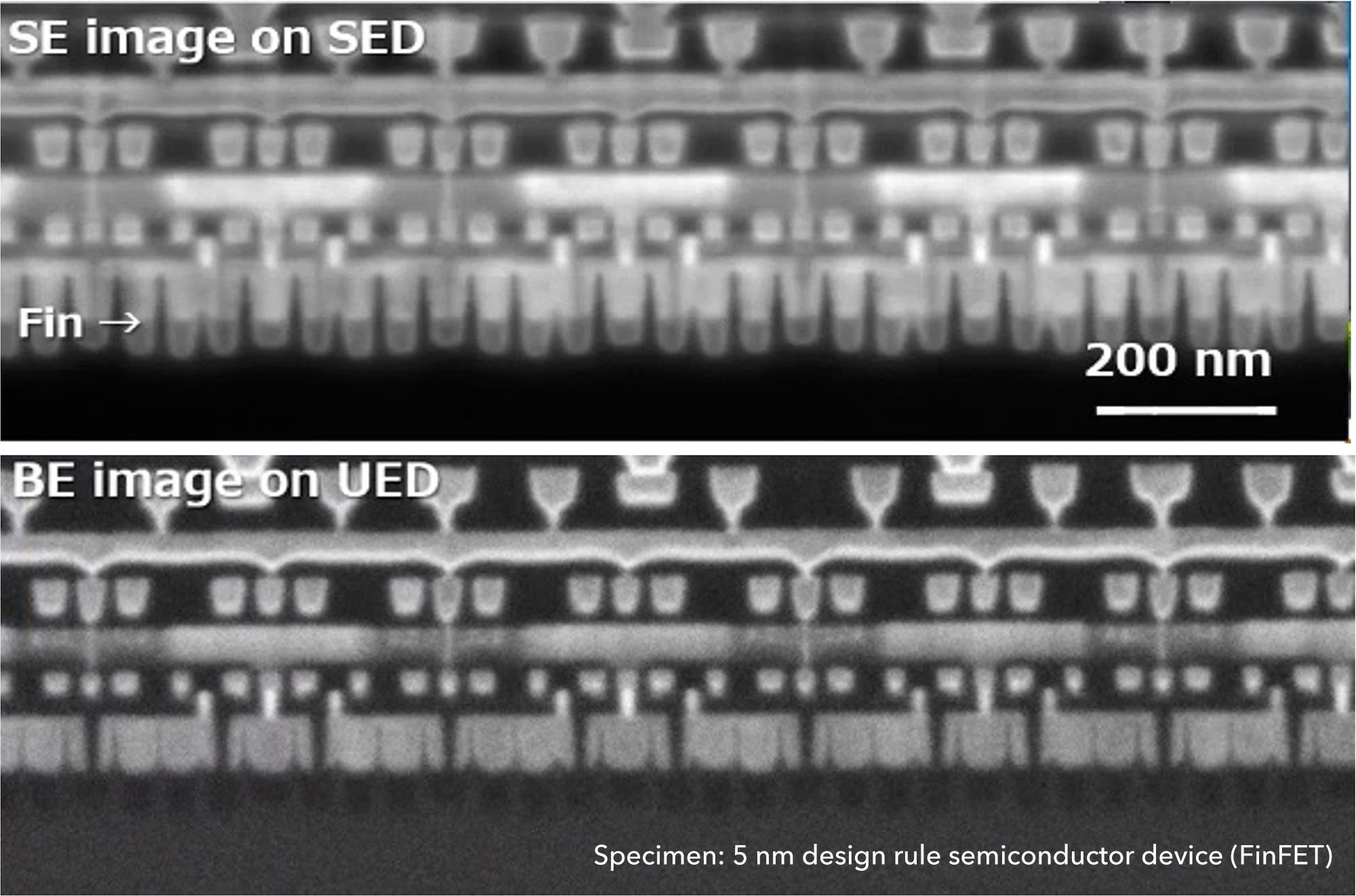
!SEM imaging of FIB-prepared cross section
超小型、可插拔式背散射电子检测器(RBED)即使在样品台倾斜时也可以使用。样品表面观察和需要倾斜观察的FIB截面观察,结合SED和UED检测器,各种各样检测器进行最佳的SEM观察。

样品:3D NANO闪存芯片的FIB截面 观察条件:加速电压2 kV、检测器 (左) SED 二次电子像、(中) RBED 背散射电子像、(右) UED背散射电子像
!EDS integration software*
一体化集成EDS分析软件。

HIGH-POWER & HIGH-QUALITY FIB Processing
超强性能的FIB加工
!Large-area, Fast FIB processing
FIB镜筒采用大电流Ga离子束照射(最大电流100nA)。这种大电流加工对于大面积成像和分析特别有效。
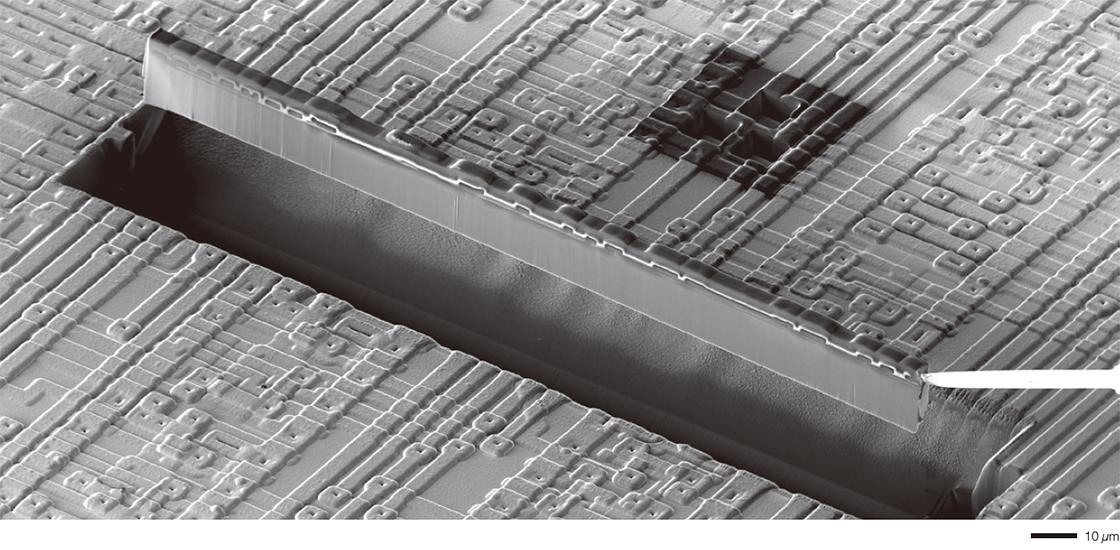
样品:半导体器件 观察条件:加速电压3 kV、检测器 SED 二次电子像 样品块200×4×15 μm。 使用OmniProbe400※采集的样品块
!Damage-layer removal by low-kV processing
FIB镜筒设置的工作距离比以前机型的短,结合新开发的电源,提高了低加速电压的处理性能。加上新的控制系统,可以进行高精度的薄膜制备中重要的低加速加工。
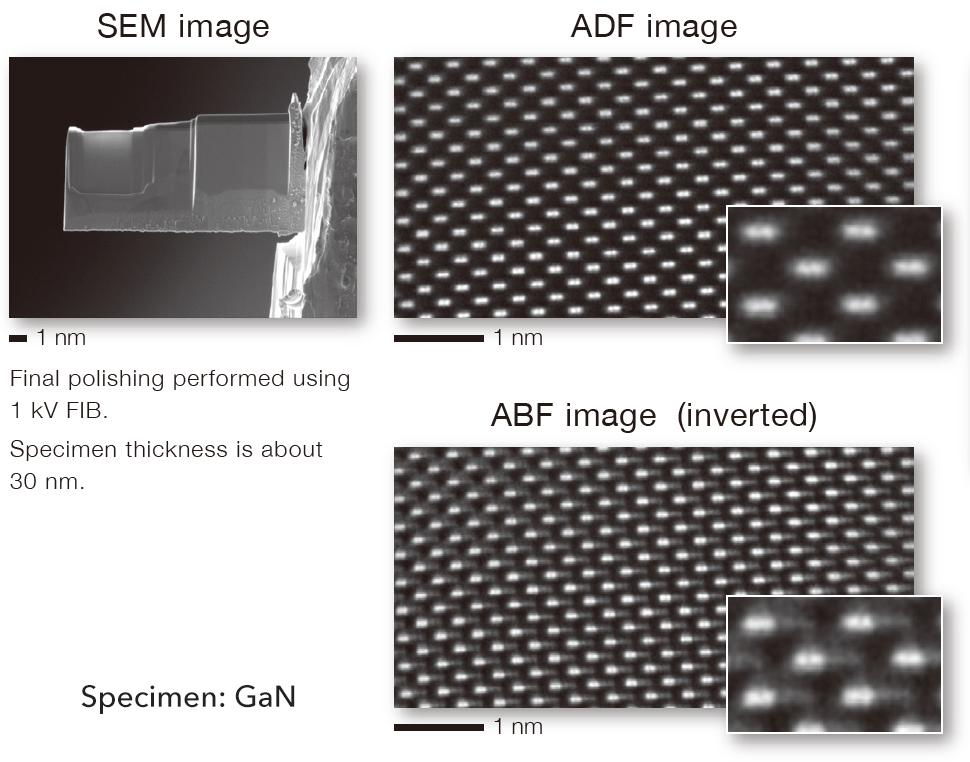
New Chamber & Stage Design
大样品室、高倾斜大型样品台
!Loading a large specimen
大样品室和新开发的5轴全对中大型马达驱动样品台。移动范围增大,可对应大样品。可以对直径130mm的样品进行全面的加工和观察。此外,80mm高的样品也可以装到样品室。
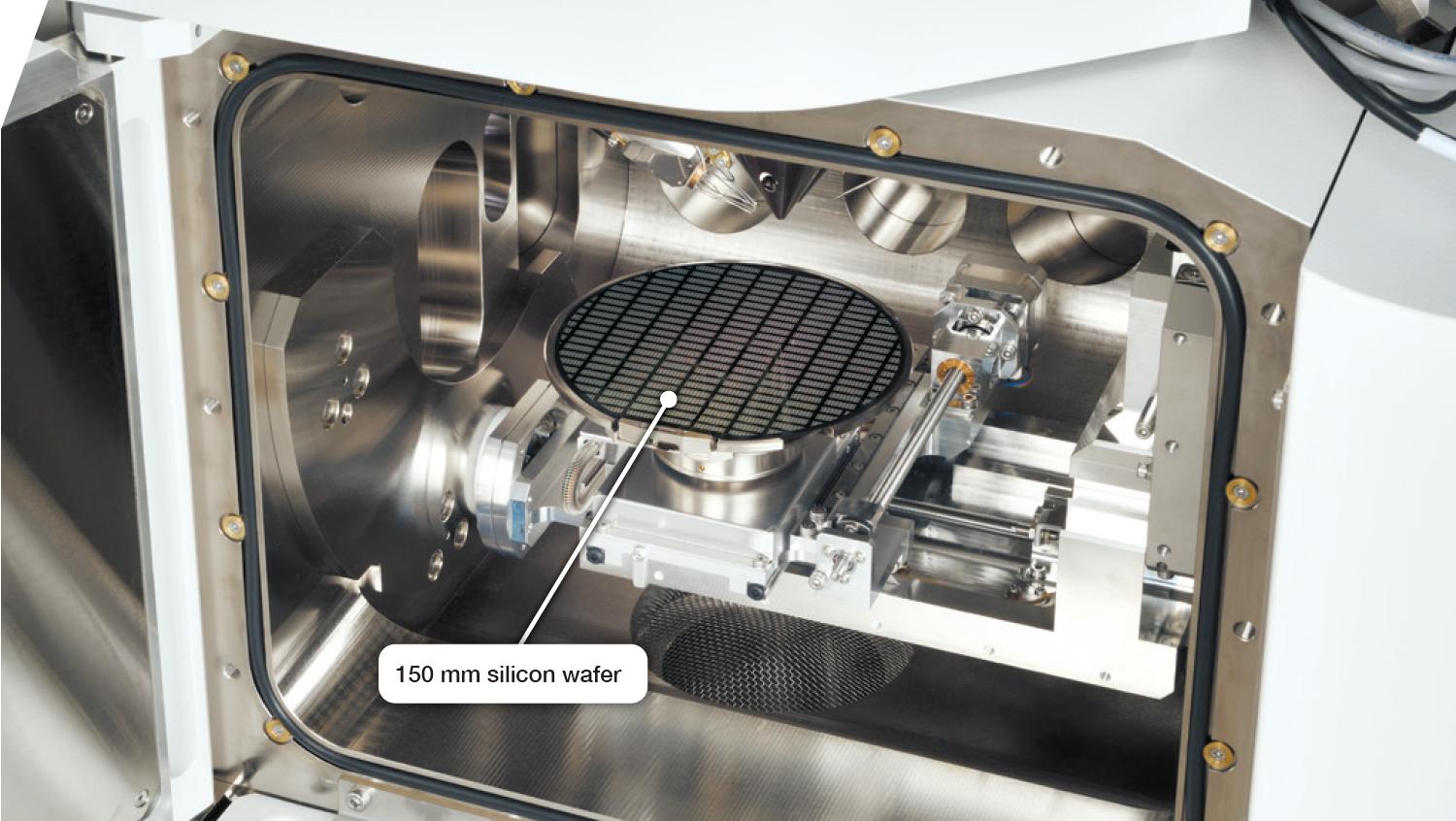

150mm硅晶片装在样品室的样子。





 扫描进入手机站
扫描进入手机站